18061770072 / 15358194655
18061770072 / 15358194655
发布时间:2022-07-25 发布时间:732 发布时间:

2021年9月,比亚迪在深圳发布e平台3.0版,比亚迪在发布会上称,在e平台上称3.0得电控单元中使用了全新一代SiC电控,功率密度提升近30%,电控更高效率99.7%。并已经被比亚迪批量应用在所售车型中!
这款SiC模块为了提升高温可靠性,充分发挥SiC高工作结温性能。采用了纳米银烧结工艺代替传统软钎焊料工艺。
当前功率半导体行业正在面临SiC和GaN等宽禁带半导体强势崛起,随着电动汽车市场的增量放大,消费者对汽车的高续航、超快充等要求越来越高,电力电子模块的功率密度、工作温度及可靠性的要求也在越来越复杂,封装成了提升可靠性和性能的关键。封装是承载器件的载体,也是保证SiC芯片可靠性、充分发挥性能的关键。
碳化硅材料的使用,减小了芯片尺寸,但芯片单位面积的功率仍然相关,这意味功率模块需要更多地依赖封装工艺和散热材料来提供散热。而当前,传统的封装工艺如软钎焊料焊接工艺已经达到了应用极限,亟需新的封装工艺和材料进行替代。
SiC芯片的工作温度更高,对封装的要求也非常高,同时对散热和可靠性的要求也更加严苛,这些都需要相配套的封装工艺和材料同步跟进。
传统功率模块中,芯片通过软钎焊接到基板上,连接界面一般为两相或三相合金系统,在温度变化过程中,连接界面通过形成金属化合物层让芯片、软钎焊料合金及基板之间形成互联。目前电子封装中常用的软钎焊料为含铅钎料或无铅钎料,其熔点基本在300℃以下,采用软钎焊工艺的功率模块结温一般低于150℃,应用于温度为175-200℃甚至200℃以上的情况时,其连接层性能会急剧退化,影响模块工作的可靠性。
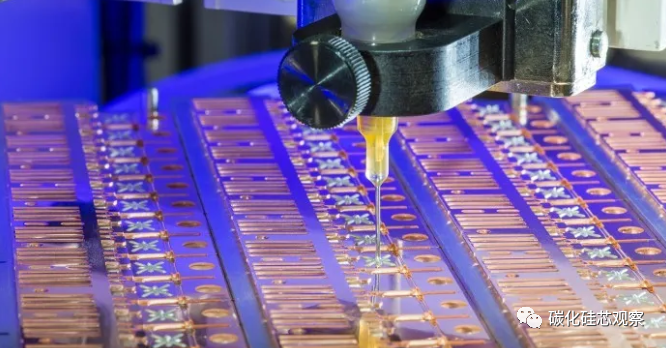
传统功率模块中,芯片通过软钎焊接到基板上,连接界面一般为两相或三相合金系统,在温度变化过程中,连接界面通过形成金属化合物层使芯片、软钎焊料合金及基板之间形成互联。目前电子封装中常用的软钎焊料为含铅钎料或无铅钎料,其熔点基本在300℃以下,采用软钎焊工艺的功率模块结温一般低于150℃,应用于温度为175-200℃甚至200℃以上的情况时,其连接层性能会急剧退化,影响模块工作的可靠性。
在功率器件中,流经焊接处的热量非常高,因此需要更加注意芯片与框架连接处的热性能及其处理高温而不降低性能的能力。烧结银的热阻要比焊料低得多,因而使用烧结银代替焊料能提高RθJC,而且由于银的熔点较高,整个设计的热裕度也提高了。
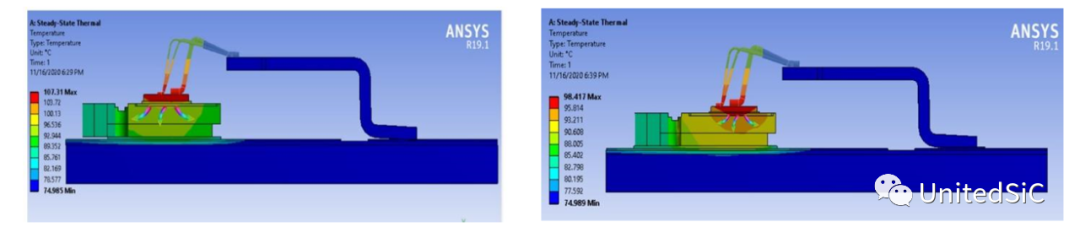
相比之下,烧结材料通常可以达到200℃-300℃,这让烧结技术成为焊接工艺理想的替代方案。此外,芯片粘接是一个极其复杂的过程,采用烧结银技术进行芯片粘接,可大大降低总制造成本,加工后无需清洗,还可缩短芯片之间的距离。

银烧结的优势总结:
Ø 纳米银烧结工艺烧结体具有优异的导电性、导热性、高粘接强度和高稳定性等特点,应用该工艺烧结的模块可长期工作在高温情况下;
Ø 纳米银烧结工艺在芯片烧结层形成可靠的机械连接和电连接,半导体模块的热阻和内阻均会降低,整体提升模块性能及可靠性;
Ø 烧结料为纯银材料,不含铅,属于环境友好型材料。
2006年英飞凌推出了Easypack1的封装形式,分别采用单面银烧结技术和双面银烧结技术。通过相应的高温循环测试发现,相比于传统软钎焊工艺,采用单面银烧结技术的模块寿命提高了5-10倍,而采用双面银烧结技术的模块寿命提高了10以上。
之后2007年,赛米控推出了SkinTer技术,芯片和基板之间采用精细银粉银烧结工艺进行连接,在250℃及压力辅助条件下得到低孔隙率银层。相比于钎焊层,功率循环能力提升了2-3倍,烧结层厚度减少约70%,热导率约提升3倍。
2012年,英飞凌推出了XT互联技术,芯片和基板之间采用银烧结技术连接。循环试验表明,无底板功率模块寿命提升达2个数量级,有底板模块寿命提升也在10倍以上。
2015年,三菱电机采用银烧结技术制作功率模块,循环寿命是软钎焊料的5倍左右。
今年5月,东芝称新发布的用于碳化硅(SiC)功率模块的封装技术iXPLV,能够使产品的可靠性提升一倍,同时减少 20% 的封装尺寸。
几个月前,斯达在国内会议上也表示,公司T6系列汽车级的单管,1200V和750V,芯片采用的银烧结工艺。双面冷却的N3和N7系列,今年年底也会有相应的碳化硅的版本数量,结构同样采用双面银烧结技术。
随着汽车的电子化和EV、HEV的实用化以及SiC/GaN器件的亮相等,车载功率半导体正在走向多样化。比如,不仅是单体的功率MOSFET,将控制IC(电路)一体化了的IPD(IntelligentPowerDevice)也面世且品种不断增加。多样化了的车载功率半导体,尤其是EV和HEV用车载功率半导体的耗电量不断增加,为了应对这个问题,就要求封装实现(1)低电阻、(2)高散热、(3)高密度封装。而烧结银工艺正是解决这一难题的关键技术。
压力,温度和时间是烧结质量的主要影响因素,镀层类型和质量,芯片面积大小和烧结气氛保护也是需要考虑的重要因素。相信随着以SiC 为住的宽禁带半导体的应用场景的扩大时,烧结银技术将得到更为广泛的应用和推广。
免责申明:本文文章转自于 微安 碳化硅芯观察,文本、素材、图片版权等内容属于原作者,本站转载内容仅供大家分享学习。如果侵害了原著作者得合法权益,请及时联系我们,我们会安排删除相关内容。